技術紹介
両面電極パッケージ
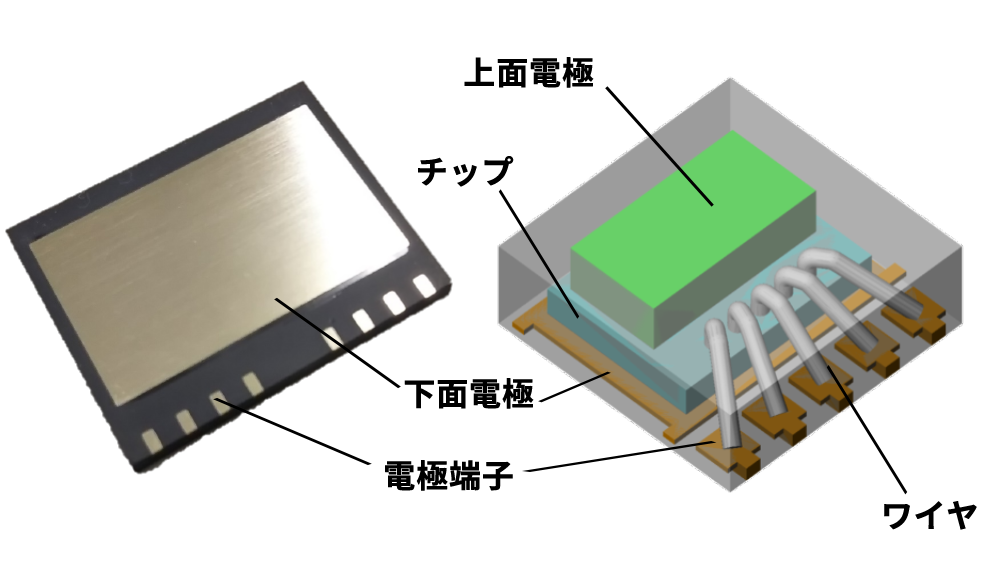
特長
- 大電流に対応可能
一般品と比較して16%電流が多く流せます
(放熱シミュレーションより算出) - 高放熱パッケージが製作可能
- リード付きタイプも製作可能
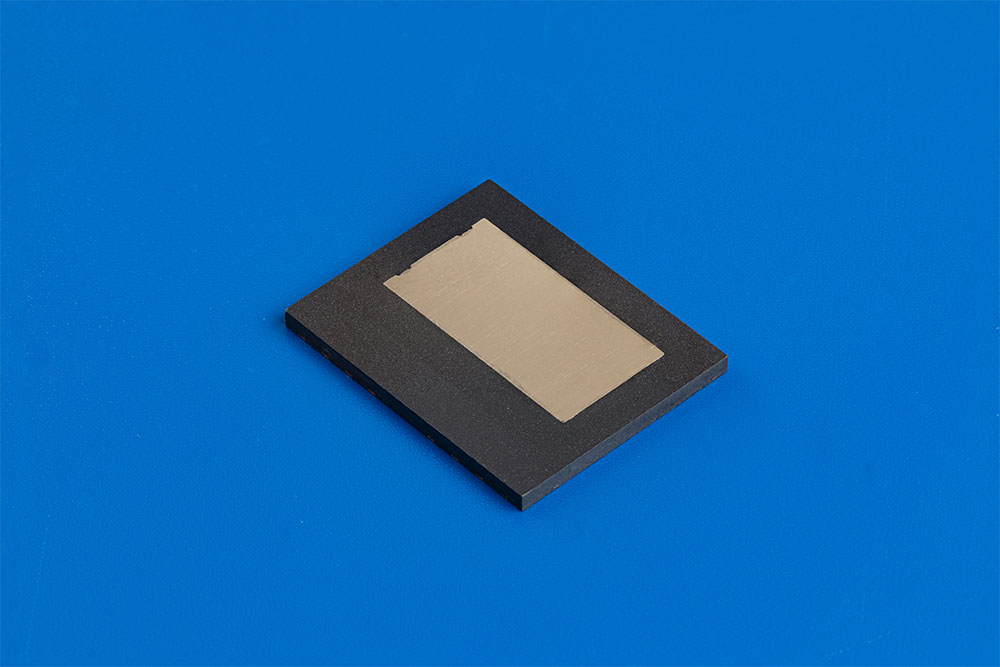
表
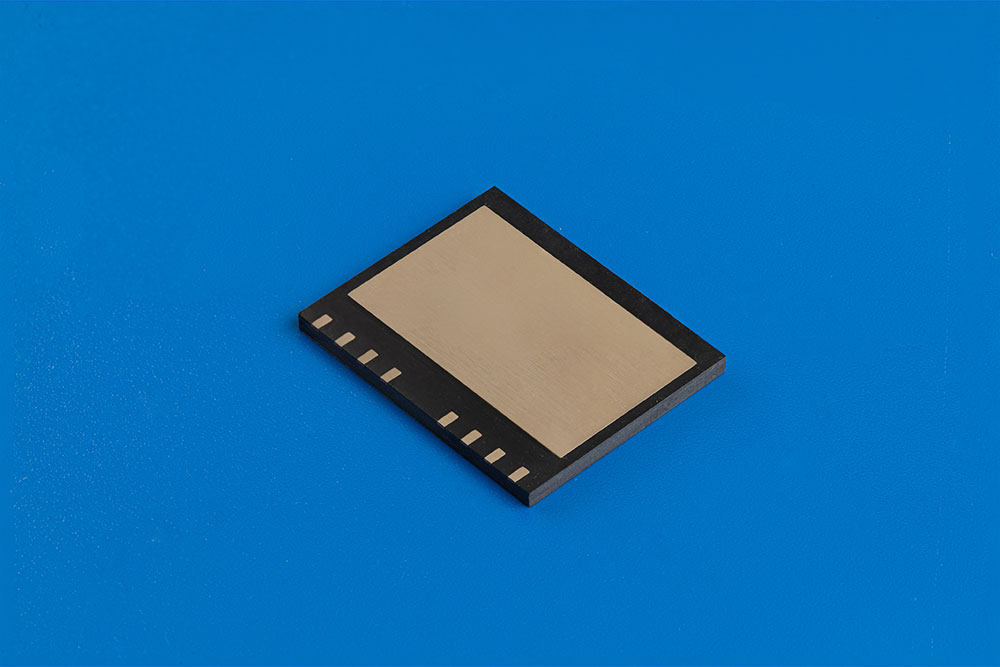
裏
センサパッケージ「開口モールド」
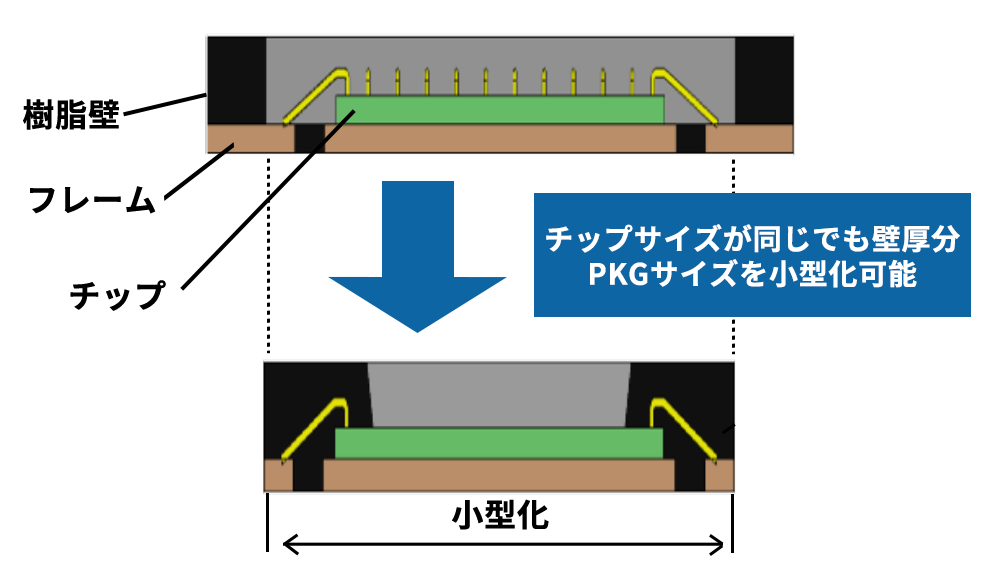
特長
基板やフレームにチップ、ワイヤボンディング組立後、
センサエリア以外の領域に樹脂壁成型が可能
効果
- 外形寸法小型化
(□7mmの場合、面積比約50%削減) - 基板・ガラスの低コスト化
- 組立後のワイヤ高信頼性
- 樹脂壁厚化による高耐湿性
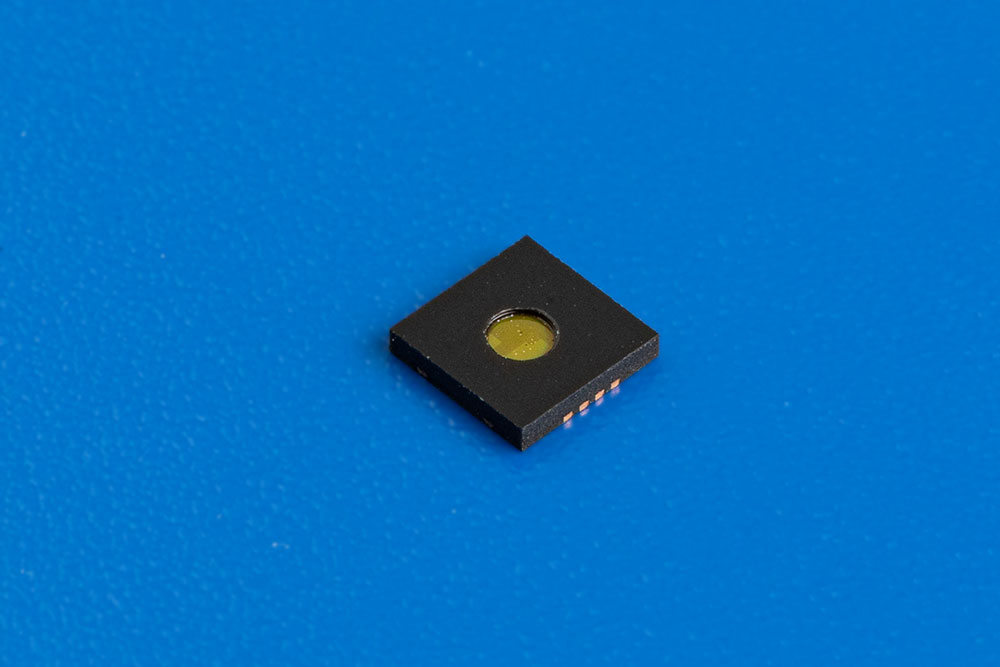
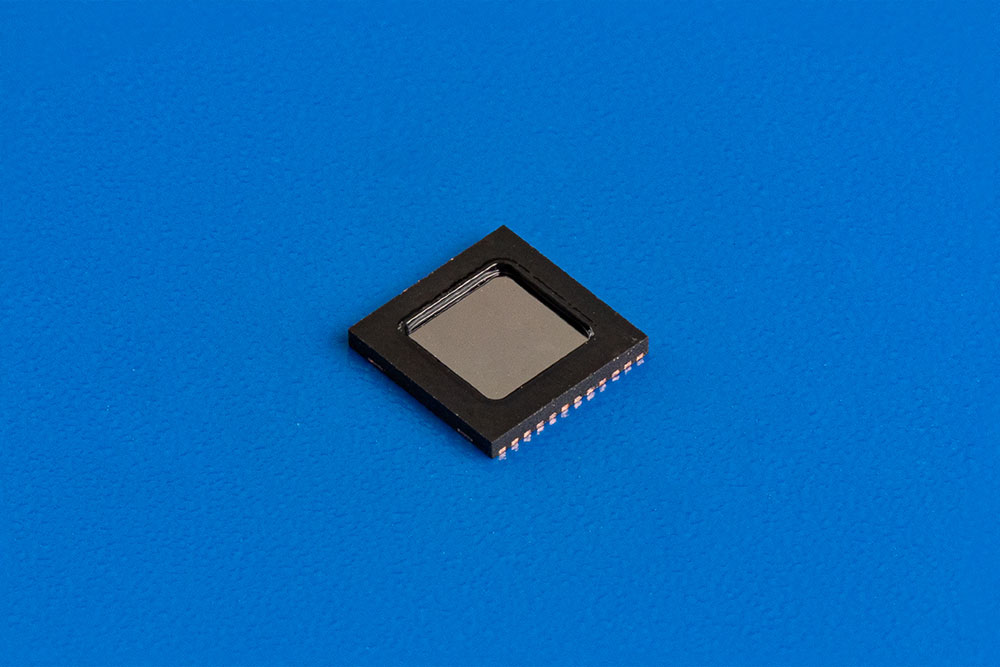
低価格・短納期試作


特長
- 高速試作対応
フレーム、基板、モールド金型、リード成型金型の新規設計が伴う場合でも短納期での少量試作が可能 - ソフトによる、放熱特性、応力等各種シミュレーション解析
- 3Dプリンタによる外形サンプル作成
モジュール実装技術
ベアチップ及びチップ部品等を複数搭載することで、小型化や高密度化したマルチチップモジュールの製作が可能です

技術1
ボイド対策
真空リフローによる対策
真空効果によりボイドが減少

技術2
3次元部品実装の実現
- 対象物へ非接触
- 高位置精度
技術3
フラックス残渣対策
各還元ガス仕様によるフレックスレスの提案
- 水素リフロー
水素ガス還元によりフラックス不要 - ギ酸リフロー
ギ酸ガス還元によりフラックス不要
技術4
実装時の位置精度向上
- 高位置精度決め治具の使用
- フレーム形状変更
- 表面処理変更
当社は超精密加工技術を中核に、半導体事業・樹脂成型事業・装置事業・自動車部品事業の4事業を展開しています。
それぞれ独立した運営をする一方、互いの技術を融合させた新製品開発や、高効率生産ラインを自社独自技術で構築できることを強みとしています。